Поле заряда, расположенного под границей двух диэлектриков - раздел Электроника, Твердотельная электроника Рассмотрим Случай Экранировки Зарядов На Рисунке 3.24. Заряд Q0...
Рассмотрим случай экранировки зарядов на рисунке 3.24. Заряд q0 расположен в среде I с диэлектрической постоянной ε = ε1. Требуется найти поле, создаваемое зарядом q0 в среде II с диэлектрической постоянной ε = ε2. Оказывается, что в общем случае невозможно подобрать систему зарядов, которые бы давали одновременно правильное значение поля и потенциала одновременно в обеих средах I и II. Поэтому поле в среде I будем искать как поле двух зарядов q1 и q2, а поле в среде II – как поле заряда q3, расположенного в той же точке, что и заряд q1. Конечно, физически существует только заряд q0, поле и потенциалы в средах I и II получаются из-за поляризации диэлектриков. Однако оказывается, что подход с введением фиктивных зарядов q1, q2 и q3 удобен и позволяет правильно рассчитывать распределение полей и потенциалов в сложных слоистых системах. Выберем величину заряда q2 = -αq1, разницу в величинах ε1, ε2 включим в множитель α. Тогда получим выражения для нормальной (En) и тангенциальной (Eτ) составляющих электрического поля, изображенных на рисунке 3.24.

Рис. 3.24. Схема, поясняющая экранировку зарядов границей раздела двух диэлектриков
Сверху границы в области I, где поле определяется зарядами q1 и q2, находящимися на на расстоянии τ от границы в среде с диэлектрической проницаемостью ε1,
 ,
,
 . (3.137)
. (3.137)
Снизу границы в области II, где поле определяется зарядом q3 в среде с ε1,
 ,
,
 . (3.138)
. (3.138)
Используя условие постоянства на границе двух диэлектрических сред тангенциальной составляющей напряженности электрического поля  и нормальной составляющей индукции электрического поля
и нормальной составляющей индукции электрического поля  , получаем:
, получаем:
 ,
,
 , (3.139)
, (3.139)
где  .
.
Отсюда следует, что
 . (3.140)
. (3.140)
Таким образом, для правильного рассмотрения электрического поля и потенциала, создаваемого зарядом q0 в среде I с ε1 и находящегося под границей со средой II с ε2, необходимо при расчете поля в среде I с диэлектрической постоянной ε1 пользоваться зарядами q1 и q2, расположенными равноудаленно от границы раздела. Величина q2 = -αq1, где α приведена в (3.140). Для расчета поля в среде II с диэлектрической постоянной ε2 необходимо пользоваться зарядом q3 = βq1, расположенным на месте заряда q1 в среде I с диэлектрической постоянной ε1.
Потенциал заряда в МДП‑структуре
Рассмотрим случай, когда точечный заряд находится на границе раздела окисел – полупроводник. Экранировка происходит только затвором структуры (слабая инверсия, низкая плотность поверхностных состояний, стандартное легирование). На рисунке 3.25 изображена возникшая ситуация. Рассмотрим случай, когда нужно сначала рассмотреть поле в окисле структуры. Заряд q, находящийся на границе, отразится зеркально затвором -q, но в этом случае заряд -q – это заряд над границей двух диэлектриков. Из-за поляризации для получения правильного поля в окисле необходимо ввести заряд αq, находящийся по другую сторону на таком же расстоянии от границы раздела. Этот заряд αq в свою очередь снова отразится в затворе и даст заряд -αq. Таким образом, правильное поле в окисле в случае трехслойной МДП‑системы получается только при бесконечном наборе зарядов слева и справа от границы раздела.
Для расчета поля и потенциала в полупроводнике все заряды слева на рисунке 3.25 мы должны уменьшить в β раз согласно предыдущему рассмотрению. Следовательно, величина поля и потенциала в полупроводнике МДП‑структуры обусловлена суммой зарядов +q и противоположного по знаку -βq, +βαq, -βα2q и т.д., отстоящих на расстояние 2dox, 4dox, 6dox, 8dox от границы раздела окисел – полупроводник.

Рис. 3.25. Схема зарядов, необходимая для расчета электрического поля и потенциала МДП‑структуры:
а) в диэлектрике; б) в полупроводнике
Условие электронейтральности соблюдено, заряд слева и справа суммарно равны между собой. Поскольку мы предположили, что заряд находится на границе раздела окисел-полупроводник, то
 .
.
Таким образом, потенциал, создаваемый в полупроводнике точечным зарядом, находящимся на границе окисел – полупроводник при экранировке затвором МДП‑структуры, на расстоянии λ вглубь и ρ в плоскости границы раздела можно вписать в виде потенциала распределенного диполя:

 . (3.141)
. (3.141)
В случае равенства диэлектрических постоянных полупроводника и диэлектрика ε1 = ε2 = ε*, β = 1, α = 0 получаем потенциал простого диполя:
 . (3.142)
. (3.142)
Как следует из соотношений (3.141) и (3.142), различие в потенциалах простого и рассредоточенного диполя будет проявляться при высоких различиях в диэлектрических постоянных окисла и полупроводника, большой толщине диэлектрика dox, высоких значениях (по сравнению с толщиной окисла) расстояния вглубь полупроводника λ, где рассчитывается потенциал.
3.7.5. Потенциальный рельеф в МДП‑структуре при дискретности элементарного заряда
Для нахождения вида потенциального рельефа в МДП‑структуре воспользуемся методом математического моделирования. Для этого, используя датчик случайных чисел, на площадке S, соответствующей в случае МДП‑структуры границе раздела полупроводник – диэлектрик, разбрасываются N единичных точечных зарядов со средней плотностью  . Потенциал каждого заряда рассчитывается с учетом экранировки затвором МДП‑структуры по уравнению (3.141). Как и прежде, предполагается, что реализовано условие слабой инверсии или обеднения и толщина подзатворного диэлектрика dox меньше ширины ОПЗ.
. Потенциал каждого заряда рассчитывается с учетом экранировки затвором МДП‑структуры по уравнению (3.141). Как и прежде, предполагается, что реализовано условие слабой инверсии или обеднения и толщина подзатворного диэлектрика dox меньше ширины ОПЗ.
Для нахождения вида потенциального рельефа потенциалы всех зарядов суммировались и из полученного значения вычиталось среднее значение величины поверхностного потенциала  , соответствующее квазинепрерывному и равномерному распределению встроенного заряда со средней плотностью
, соответствующее квазинепрерывному и равномерному распределению встроенного заряда со средней плотностью  .
.
На рисунке 3.26 приведена полученная таким образом картина потенциального рельефа. Из рисунка видно, что потенциальный рельеф негладкий, на нем имеются «озера» – участки со значительно меньшим уровнем поверхностного потенциала, «горные хребты» – участки со значительно большим уровнем поверхностного потенциала и, наконец, «долины» – области, где поверхностный потенциал близок к среднему. На приведенной шкале пространственного масштаба видно, что характерный размер областей «озер» и «горных хребтов» составляет порядка 500 Å при толщине диэлектрика dox в МДП‑структуре dox = 50 Å.

Рис. 3.26. Форма потенциального рельефа в МДП‑структуре в области слабой инверсии. Сплошные линии соответствуют отклонению потенциала ψs от среднего значения  на величину среднеквадратичной флуктуации σψ. Точки соответствуют местам расположения зарядов
на величину среднеквадратичной флуктуации σψ. Точки соответствуют местам расположения зарядов
На рисунке 3.27 приведена зависимость поверхностного потенциала ψs от координаты y вдоль границы раздела полупроводник – диэлектрик, рассчитанная для случая, приведенного на рисунке 3.26. Из данного рисунка также видно, что зависимость потенциала ψs от координаты является немонотонной функцией.
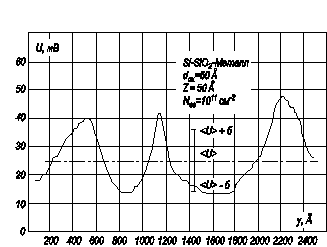
Рис. 3.27. Зависимость потенциала ψs от координаты y вдоль поверхности
Таким образом, дискретность и случайный характер расположения в плоскости границы раздела полупроводник – диэлектрик встроенного заряда вызывают флуктуации относительного среднего значения величины поверхностного потенциала.
Все темы данного раздела:
Твердотельная электроника
Учебное пособие
Петрозаводск 2004
ББК 22.37
УДК 539.2
Г 957
Гуртов, В. А.
Г957 Твердотельная электроника: Учеб. пособие / В. А. Гуртов; ПетрГУ. – Петрозаводск, 2004. – 312 с.
ISBN 5‑8021‑0319‑1
В учебном
Зонная структура полупроводников
Согласно постулатам Бора энергетические уровни для электронов в изолированном атоме имеют дискретные значения. Твердое тело представляет собой ансамбль отдельных атомов, химическая связь между кото
Статистика электронов и дырок в полупроводниках
Равновесные процессы – процессы, происходящие в телах, которые не подвергаются внешним воздействиям. В состоянии термодинамического равновесия для данного образца кристалла при заданной температуре
Распределение квантовых состояний в зонах
Стационарные состояния электрона в идеальном кристалле характеризуются квазиимпульсом р. Запишем принцип неоднородностей Гейзенберга для квазиимпульсов dpx, dpy
Концентрация носителей заряда и положение уровня Ферми
Электроны, как частицы, обладающие полуцелым спином, подчиняются статистике Ферми – Дирака. Вероятность того, что электрон будет находиться в квантовом состоянии с энергией Е, выражается фун
Концентрация электронов и дырок в собственном полупроводнике
Напомним, что полупроводник называется собственным, если в нем отсутствуют донорные и акцепторные примеси. В этом случае электроны появляются в зоне проводимости только за счет теплового заброса из
Концентрация электронов и дырок в примесном полупроводнике
Уравнение (1.14) справедливо только для равновесных носителей заряда, то есть в отсутствие внешних воздействий. В наших обозначениях
Определение положения уровня Ферми
В предыдущих рассуждениях мы считали, что уровень Ферми задан. Посмотрим теперь, как можно найти положение уровня Ферми.
Для собственного полупроводника уравнение электронейтральности прио
Проводимость полупроводников
При приложении электрического поля к однородному полупроводнику в последнем протекает электрический ток. При наличии двух типов свободных носителей – электронов и дырок – проводимость σ
Токи в полупроводниках
Как уже отмечалось выше, проводимость, а следовательно, и ток в полупроводниках обусловлены двумя типами свободных носителей. Кроме этого, также есть две причины, обуславливающие появление электрич
Неравновесные носители
Образование свободных носителей заряда в полупроводниках связано с переходом электронов из валентной зоны в зону проводимости. Для осуществления такого перехода электрон должен получить энергию, до
Уравнение непрерывности
Динамика изменения неравновесных носителей по времени при наличии генерации и рекомбинации в полупроводнике, а также при протекании электрического тока определяется уравнением непрерывности. Для по
Ток термоэлектронной эмиссии
Рассчитаем ток эмиссии электронов с поверхности полупроводника в условиях термодинамического равновесия. Все свободные электроны в полупроводнике находятся в потенциальной яме. Функция распределени
Эффект поля, зонная диаграмма при эффекте поля
Рассмотрим зонную диаграмму приповерхностной области полупроводников в равновесных условиях. Рассмотрим, как будет меняться концентрация свободных носителей в приповерхностной области полупроводник
Концентрация электронов и дырок в области пространственного заряда
Рассчитаем, как меняется концентрация электронов и дырок в области пространственного заряда. Для определенности рассмотрим полупроводник n‑типа. В условиях термодинамического равновеси
Дебаевская длина экранирования
Количественной характеристикой эффекта поля, характеризующей глубину проникновения поля в полупроводник, является дебаевская длина экранирования. Рассмотрим случай, когда полупроводник внесен во вн
Зонная диаграмма барьера Шоттки при внешнем напряжении
Рассмотрим, как меняется зонная диаграмма контакта металл – полупроводник при приложении внешнего напряжения VG, знак которого соответствует знаку напряжения на металлическом элек
Распределение электрического поля и потенциала в барьере Шоттки
Рассмотрим более детально, как меняются электрическое поле и потенциал в области пространственного заряда контакта металл – полупроводник в виде барьера Шоттки. Для определенности будем рассматрива
Гетеропереходы
Гетеропереходом называют контакт двух полупроводников различного вида и разного типа проводимости, например, pGe – nGaAs. Отличие гетеропереходов от обычного p‑n п
Зонная диаграмма приповерхностной области полупроводника в равновесных условиях
Будем рассматривать изменение энергетического спектра свободных носителей заряда в приповерхностной области полупроводника под действием внешнего электрического поля. При этом будем считать, что на
Уравнение Пуассона для ОПЗ
Запишем уравнение Пуассона для полупроводника p-типа:
(3.6)
Величина ρ
Выражение для заряда в ОПЗ
Выражение (3.18) для заряда в ОПЗ, полученное в предыдущем параграфе, справедливо для любых значений поверхностного потенциала. Однако использование его для конкретных случаев довольно затруднено в
Избыток свободных носителей заряда
Важной характеристикой ОПЗ является значение заряда свободных носителей (электронов или дырок) Qp,n или, если выразить этот заряд в единицах элементарного заряда, велич
Среднее расстояние локализации свободных носителей от поверхности полупроводника
Для ряда процессов, протекающих в ОПЗ, важной характеристикой является среднее расстояние lc, на котором локализованы свободные носители заряда, электроны
Форма потенциального барьера на поверхности полупроводника
При решении уравнения Пуассона в разделе 3.2.1 нами был получен первый интеграл в виде (3.16). Для нахождения формы потенциального барьера, т.е. зависимости электростатического потенциала ψ
Обеднение и слабая инверсия в примесном полупроводнике
Для этой области, как следует из (3.15), функция F(ψ, φ0) имеет совсем простой вид. Второй интеграл уравнения Пуассона при этом будет равен:
Область обогащения и очень сильной инверсии в примесном полупроводнике
Будем рассматривать область изменения поверхностного потенциала ψs, когда для зарядов в ОПЗ справедливы соотношения (3.19) и (3.22). Получим форму потенциального барьера &
Емкость области пространственного заряда
Поскольку полный заряд в ОПЗ Qsc зависит от величины поверхностного потенциала ψs, то область пространственного заряда обладает определенной емкостью C
Влияние вырождения на характеристики ОПЗ полупроводника
При высоком уровне легирования полупроводниковой подложки или сильных изгибах зон уровень Ферми в ОПЗ может оказаться вблизи дна зоны проводимости или потолка валентной зоны. В этом случае выражени
Основные определения
Одной из принципиальных особенностей, характеризующих поверхность полупроводников или границу раздела полупроводника с каким-либо веществом, является изменение энергетического спектра для электроно
Природа поверхностных состояний
По физической природе поверхностные состояния разделяются на четыре основных типа [13]:
1) поверхностные состояния типа Тамма;
2) поверхностные состояния типа Шокл
Статистика заполнения ПС
Рассмотрим, как меняется заряд ПС при изменении величины поверхностного потенциала ψs. Функцию заполнения ПС возьмем в виде функции Ферми – Дирака. Величина энергии Ферми на
Уравнение электронейтральности
Рассмотрим более подробно связь между напряжением на затворе VG МДП‑структуры и поверхностным потенциалом ψs. Все приложенное напряжение V
Определение типа проводимости полупроводниковой подложки
Для определения типа проводимости подложки воспользуемся высокочастотной вольт‑фарадной характеристикой.
Как следует из эквивалентной схемы, приведенной на рисунке 3.13, и вида высок
Определение толщины подзатворного диэлектрика
Поскольку, как было показано ранее, в обогащении емкость МДП‑структуры определяется только геометрической емкостью диэлектрика Cox, то:
Определение величины и профиля концентрации легирующей примеси
Для определения величины легирующей концентрации воспользуемся следующим свойством высокочастотных C‑V характеристик МДП‑структур: их емкость в области инверсии достигает
Определение величины и знака встроенного заряда
Для определения величины и знака встроенного в диэлектрик МДП‑структуры заряда обычно пользуются высокочастотным методом ВФХ. Для этого, зная толщину подзатворного диэлектрика dox
Дифференциальный метод
Дифференциальный метод, или метод Термана, основан на сравнении экспериментальной высокочастотной емкости МДП‑структуры с теоретической расчетной емкостью идеальной МДП‑структуры с таки
Интегральный метод
Интегральный метод, или метод Берглунда, основан на анализе равновесной низкочастотной вольт-фарадной характеристики. Поскольку для равновесной низкочастотной C‑V кривой справед
Температурный метод
Температурный метод, или метод Грея – Брауна, основан на анализе изменения напряжения плоских зон VFB МДП‑структуры при изменении температуры T. При изменении темпера
Виды флуктуаций поверхностного потенциала
Предыдущее рассмотрение электрофизических процессов в МДП‑структурах неявно предполагало, что такие параметры, как величина встроенного заряда Qox, толщина подзатворного диэ
Конденсаторная модель Гоетцбергера для флуктуаций поверхностного потенциала
Пусть флуктуации поверхностного потенциала обусловлены крупномасштабными технологическими флуктуациями плотности встроенного в диэлектрик заряда Qox = qNox. Толщ
Среднеквадратичная флуктуация потенциала, обусловленная системой случайных точечных зарядов
Рассмотрим систему зарядов на бесконечной плоскости, координата каждого из которых является случайной функцией. Заряды будем считать малыми и находящимися в узлах со средним расстоянием между узлам
Потенциал, создаваемый зарядом, находящимся на границе двух сред с экранировкой
Как было показано, величина среднеквадратичной флуктуации потенциала σψ определяется потенциалом единичного точечного заряда при случайном их распределении. В связи с эт
Функция распределения потенциала при статистических флуктуациях
При рассмотрении флуктуаций поверхностного потенциала вопрос о нахождении вида функций распределения является одним из важных. Поскольку заряженные центры в МДП‑структуре дискретны и случайны
Зависимость величины среднеквадратичной флуктуации от параметров МДП-структуры
Как следует из разделов 3.7.3 и 3.7.4, для случая слабой инверсии можно получить зависимость величины среднеквадратичной флуктуации от параметров МДП‑структуры. Подставим значение для потенци
Пространственный масштаб статистических флуктуаций
Рассмотрим, какой характерный пространственный масштаб имеют статистические флуктуации поверхностного потенциала в МДП‑структурах. Пусть на границе раздела полупроводник – диэлектрик находятс
Выпрямление в диоде
Одним из главных свойств полупроводникового диода на основе p‑n перехода является резкая асимметрия вольт‑амперной характеристики: высокая проводимость при прямом смещении и низк
Характеристическое сопротивление
Различают два вида характеристического сопротивления диодов: дифференциальное сопротивление rD и сопротивление по постоянному току RD.
Дифференциальное
Варикапы
Зависимость барьерной емкости СБ от приложенного обратного напряжения VG используется для приборной реализации. Полупроводниковый диод, реализующий эту зависимос
Влияние генерации, рекомбинации и объемного сопротивления базы на характеристики реальных диодов
В реальных выпрямительных диодах на основе p‑n перехода при анализе вольт‑амперных характеристик необходимо учитывать влияние генерационно-рекомбинационных процессов в обедненной
Влияние объемного сопротивления базы диода на прямые характеристики
База диода на основе p‑n перехода обычно легирована существенно меньше, чем эмиттер. В этом случае омическое сопротивление квазинейтральных областей диода будет определяться сопротивле
Влияние температуры на характеристики диодов
Как уже отмечалось, при прямом смещении ток диода инжекционный, большой по величине и представляет собой диффузионную компоненту тока основных носителей. При обратном смещении ток диода маленький п
Стабилитроны
Стабилитроном называется полупроводниковый диод, вольт‑амперная характеристика которого имеет область резкой зависимости тока от напряжения на обратном участке вольт̴
Туннельный пробой в полупроводниках
Проанализируем более подробно механизмы туннельного и лавинного пробоя.
Рассмотрим зонную диаграмму диода с p‑n переходом при обратном смещении при условии, чт
Лавинный пробой в полупроводниках
Рассмотрим случай однородного электрического поля в полупроводнике. Если двигаясь вдоль силовых линий электрического поля электрон на расстоянии, равном длине свободного пробега λ, н
Приборные характеристики стабилитронов
Основными характеристиками стабилитрона являются ток Iст и напряжение Uст стабилизации, дифференциальное напряжение стабилитрона rст
Туннельный и обращенный диоды
Туннельным диодом называют полупроводниковый диод на основе p+‑n+ перехода с сильнолегированными областями, на прямом участке вольт-амперной
Переходные процессы в полупроводниковых диодах
При быстрых изменениях напряжения на полупроводниковом диоде на основе обычного p‑n перехода значение тока через диод, соответствующее статической вольт-амперной характеристике, устана
Основные физические процессы в биполярных транзисторах
В рабочем режиме биполярного транзистора протекают следующие физические процессы: инжекция, диффузия, рекомбинация и
Биполярный транзистор в схеме с общей базой. Зонная диаграмма и токи
На рисунке 5.6а показана зонная диаграмма биполярного транзистора в схеме с общей базой в условиях равновесия. Значками (+) и (–) на этой диаграмме указаны основные и неосновные носители.
Дифференциальные параметры биполярных транзисторов в схеме с общей базой
Основными величинами, характеризующими параметры биполярного транзистора, являются коэффициент передачи тока эмиттера α, сопротивление эмиттерного (rэ), и коллекторног
Коэффициент инжекции
Рассмотрим более подробно выражение для коэффициента переноса, для этого проанализируем компоненты эмиттерного тока, как показано на диаграмме (рис. 5.10).
Коэффициент переноса. Фундаментальное уравнение теории транзисторов
Коэффициент передачи эмиттерного тока a характеризует изменение коллекторного тока Iк при вызвавшем его изменении эмиттерного тока Iэ.
Ток коллек
Дифференциальное сопротивление эмиттерного перехода
Из выражения (5.7) для ВАХ биполярного транзистора легко получить общее выражение для дифференциального сопротивления эмиттерного перехода:
Дифференциальное сопротивление коллекторного перехода
Дифференциальное сопротивление коллекторного перехода rк определяется как
.
Коэффициент обратной связи
Коэффициент обратной связи по напряжению в биполярном транзисторе в схеме с общей базой показывает, как изменится напряжение на эмиттерном переходе при единичном изменении напряжения на коллекторно
Объемное сопротивление базы
Объемное сопротивление базы БТ в схеме с общей базой определяется чисто геометрическими особенностями конструкции БТ. Для сплавного транзистора, как показано на рисунке 5.14, общее сопротивление бу
Тепловой ток коллектора
Тепловым током коллектора Iк0 называют коллекторный ток Iк, измеренный в режиме разомкнутого эмиттерного перехода (режим холостого хода в эмиттерной цепи I
Биполярный транзистор в схеме с общим эмиттером
Схема включения биполярного транзистора с общим эмиттером приведена на рисунке 5.15:
Характеристики транзистора в этом режиме будут отличаться от характеристик в режиме с общей базой. В тр
Дрейфовые транзисторы
В предыдущих разделах рассматривался перенос инжектированных носителей через базу биполярного транзистора. Процесс переноса являлся диффузионным, поскольку электрическое поле в базе отсутствует. Пр
Параметры транзистора как четырехполюсника.
h-параметры
Биполярный транзистор в схемотехнических приложениях представляют как четырехполюсник и рассчитывают его параметры для такой схемы. Для транзистора как чет
Система z-параметров
Зададим в качестве входных параметров биполярного транзистора как четырехполюсника токи I1 и I2, а напряжения U1 и U2 будем о
Частотные и импульсные свойства транзисторов
Процесс распространения инжектированных в базу неосновных носителей заряда от эмиттерного до коллекторного перехода идет диффузионным путем. Этот процесс достаточно медленный, и инжектированные из
Глава 6. Полевые транзисторы
Физической основой работы полевого транзистора со структурой металл – диэлектрик – полупроводник является эффект поля. Напомним, что эффект поля состоит в том, что под действием внешнего электричес
Характеристики МОП ПТ в области плавного канала
Рассмотрим полевой транзистор со структурой МДП, схема которого приведена на рисунке 6.2. Координата z направлена вглубь полупроводника, y – вдоль по длине канала и х – по шири
Характеристики МОП ПТ в области отсечки
Как следует из уравнения (6.9), по мере роста напряжения исток‑сток VDS в канале может наступить такой момент, когда произойдет смыкание канала, т.е. заряд электронов в кана
Эффект смещения подложки
Рассмотрим, как меняются характеристики МДП‑транзистора при приложении напряжения между истоком и подложкой. Отметим, что приложенное напряжение между истоком и подложкой при условии наличия
Малосигнальные параметры
Для МДП‑транзистора характерны следующие малосигнальные параметры: крутизна характеристики S , внутреннее сопротивление Ri, коэффициент усиления m. Крутизна пе
Методы определения параметров МОП ПТ из характеристик
Покажем, как можно из характеристик транзистора определять параметры полупроводниковой подложки, диэлектрика и самого транзистора. Длину канала L и ширину W обычно знают из топологии
Учет диффузионного тока в канале
Запишем выражение для плотности тока в канале МДП‑транзистора с учетом дрейфовой и диффузионной составляющих тока. Имеем:
Неравновесное уравнение Пуассона
Запишем уравнение Пуассона для ОПЗ полупроводника р‑типа, находящегося в неравновесных условиях, в виде:
Уравнение электронейтральности в неравновесных условиях
Как уже отмечалось в разделе 6, для получения в явном виде вольт-амперной характеристики транзистора необходимо найти связь между поверхностным потенциалом ψs и квазиуровнем
МОП ПТ с плавающим затвором
Полевой транзистор с плавающим затвором по принципу работы похож на МНОП‑транзистор. Только в транзисторах с плавающим затвором инжектированный заряд хранится на плавающем затворе, находящемс
Приборы с зарядовой связью
Новым типом полевых полупроводниковых приборов, работающих в динамическом режиме, являются приборы с зарядовой связью (ПЗС). На рисунке 6.19 приведена схема, поясняющая устройство и основные физиче
Физические явления, ограничивающие микроминиатюризацию
Анализ показывает, что наряду с тенденцией уменьшения геометрических размеров каждого элемента в схемах проявляется тенденция к увеличению числа элементов в схеме. Если в начале 1960‑х годов
Феноменологическое описание ВАХ динистора
Для объяснения ВАХ динистора используют двухтранзисторную модель. Из рисунка 7.5 следует, что тиристор можно рассматривать как соединение р‑n‑р транзистора с n‑р‑n
Зонная диаграмма и токи диодного тиристора в открытом состоянии
В открытом состоянии (α – велики) все три перехода смещены в прямом направлении. Это происходит вследствие накопления объемных зарядов в базах n2, p2
Тринистор
Как уже говорилось, чтобы перевести тиристор в открытое состояние, необходимо накопить избыточный отрицательный заряд в базе n1 и положительный в базе р2. Это ос
Феноменологическое описание ВАХ тринистора
Аналогично как для динистора, запишем систему уравнений для тока тиристора через эмиттерный и коллекторный p‑n переходы, с учетом управляющего тока Iу через вторую ба
Требования к зонной структуре полупроводников
Эффект Ганна наблюдается главным образом в двухдолинных полупроводниках, зона проводимости которых состоит из одной нижней долины и нескольких верхних долин [32, 33].
Для того, чтобы при п
Статическая ВАХ арсенида галлия
Получим зависимость скорости дрейфа электронов от поля υД(E) для случая отрицательного дифференциального сопротивления.
Продифференцировав уравнение
Зарядовые неустойчивости в приборах с отрицательным дифференциальным сопротивлением
Рассмотрим однородно легированный электронный полупроводник с омическими контактами, к которому приложена разность потенциалов (рис. 8.6). Создаваемое в нем электрическое поле будет E = E
Глава 9. Классификация и обозначения полупроводниковых приборов
При использовании полупроводниковых приборов в электронных устройствах для унификации их обозначения и стандартизации параметров используются системы условных обозначений. Эта система классифицируе
Условные обозначения и классификация отечественных полупроводниковых приборов
Рассмотрим на примере ОСТ 11.336.919‑81 «Приборы полупроводниковые. Система условных обозначений» систему обозначений полупроводниковых приборов, которая состоит из 5 элементов. В основу сист
Условные обозначения и классификация зарубежных полупроводниковых приборов
За рубежом существуют различные системы обозначений полупроводниковых приборов [36, 38]. Наиболее распространенной является система обозначений JEDEC, принятая объединенным техническим советом по э
Графические обозначения и стандарты
В технической документации и специальной литературе применяются условные графические обозначения полупроводниковых приборов в соответствии с ГОСТ 2.730‑73 «Обозначения условные, графические в
Условные обозначения электрических параметров и сравнительные справочные данные полупроводниковых приборов
Для полупроводниковых приборов определены и стандартизованы значения основных электрических параметров и предельные эксплутационные характеристики, которые приводятся в справочниках. К таким параме
Основные обозначения
А – постоянная Ричардсона
С – электрическая емкость
CB – барьерная емкость p-n перехода
CD – диффузионная емко
Диод выпрямительный
C – емкость диода
CБ – барьерная емкость
CD – диффузионная емкость
Cп Cd – емкость п
Биполярный транзистор
Eк EC – напряжение источника питания коллекторной цепи
h11 – входное сопротивление при коротком замыкании на выходе
Полевой транзистор
Сox – удельная емкость подзатворного диэлектрика
Iс ID – ток стока
Iз IG
Физические параметры важнейших полупроводников
Параметр
Обозначение
Si
Ge
GaAs
InSb
Ширина запрещенной зоны, эВ
300 К
Свойства диэлектриков
Eg, эВ
εст
ε∞
ρ, г-1∙см-3
Список рекомендованной литературы
1. Физика твердого тела: Энциклопедический словарь /Гл. ред. В.Г. Барьяхтар, зам. глав. ред. В. Л. Винецкий. Т. 1, 2. Киев: Наукова думка, 1998.
2. Sah C.‑T. Fundamen

 ,
, . (3.137)
. (3.137) ,
, . (3.138)
. (3.138) и нормальной составляющей индукции электрического поля
и нормальной составляющей индукции электрического поля  , получаем:
, получаем: ,
, , (3.139)
, (3.139) .
. . (3.140)
. (3.140)
 .
.
 . (3.141)
. (3.141) . (3.142)
. (3.142) . Потенциал каждого заряда рассчитывается с учетом экранировки затвором МДП‑структуры по уравнению (3.141). Как и прежде, предполагается, что реализовано условие слабой инверсии или обеднения и толщина подзатворного диэлектрика dox меньше ширины ОПЗ.
. Потенциал каждого заряда рассчитывается с учетом экранировки затвором МДП‑структуры по уравнению (3.141). Как и прежде, предполагается, что реализовано условие слабой инверсии или обеднения и толщина подзатворного диэлектрика dox меньше ширины ОПЗ. , соответствующее квазинепрерывному и равномерному распределению встроенного заряда со средней плотностью
, соответствующее квазинепрерывному и равномерному распределению встроенного заряда со средней плотностью  .
.
 на величину среднеквадратичной флуктуации σψ. Точки соответствуют местам расположения зарядов
на величину среднеквадратичной флуктуации σψ. Точки соответствуют местам расположения зарядов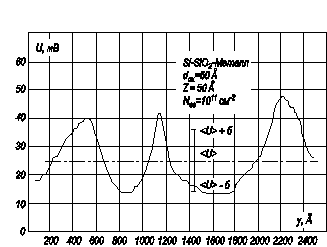







Новости и инфо для студентов